ūŅĮ³įĮüĒįĮČÓ░ļī¦¾wĄ─ąąśIĄ─ĮøõN╔╠Ę┤ė│,ūį╝║▒╗┐═æ¶ÆüŚē└▓,▀@Š┐Š╣╩Ū╩▓├┤įŁę“─ž,░ļī¦¾wąąśIę▓×ķ╩▓├┤ī”¤oēm╩ų╠ūę¬Ū¾▀@├┤Ė▀?¤oēm╩ę╩ų╠ūī┘ė┌¤oēm╩ęā╚Ą─║─▓─,▀@ŅÉ║─▓─Å─2016─Ļķ_╩╝Ż¼ę¬Ū¾▒╗ų─Ļć└Ė±,Å─2016─Ļķ_╩╝Ż¼╚½Ū“Ą─░ļī¦¾w╝╝ągšōē»ĪóĖ„čąėæĢ■Äū║§Č╝├ōļx▓╗┴╦ėæšōFOWLP (Fan Out Wafer Level PackageŻ¼╔╚│÷ą═ĘŌčb)▀@ĒŚūhŅ}ĪŻ FOWLP×ķš¹éĆ░ļī¦¾w«aśIĦüĒ╚ń┤╦┤¾Ą─ø_ō¶ąįŻ¼─¬▀^ė┌┼ż▐D┴╦╬┤üĒį┌ĘŌčb«aśI╔ŽĄ─ĮYśŗŻ¼ė░Ēæ┴╦š¹éĆĘŌčb«aśIĄ─ųŲ│╠ĪóįOéõ┼cŽÓĻPĄ─▓─┴ŽŻ¼ę▓īó▀^╚źŪ░║¾Č╬§r├„ģ^äeĄ─ųŲ│╠╚┌║Žį┌ę╗ŲĪŻ
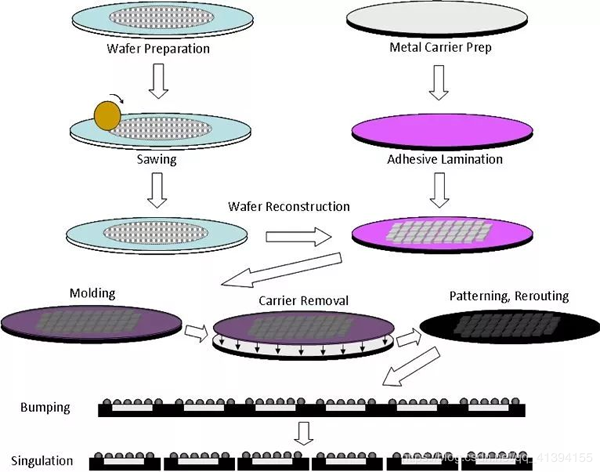
FOWLP Ż¼Ųõ▓╔╚Ī└ŁŠĆ│÷üĒĄ─ĘĮ╩ĮŻ¼│╔▒ŠŽÓī”▒Ńę╦Ż╗FOWLP┐╔ęįūīČÓĘN▓╗═¼┬ŃŠ¦Ż¼ū÷│╔Ž±WLPųŲ│╠ę╗░Ń┬±▀M╚źŻ¼Ą╚ė┌£pę╗īėĘŌčbŻ¼╝┘įOĘ┼ų├ČÓŅw┬ŃŠ¦Ż¼Ą╚ė┌╩Ī┴╦ČÓīėĘŌčbŻ¼ėąų·ė┌ĮĄĄ═┐═æ¶│╔▒ŠĪŻ
╦³║═WLPĄ─Fan Inėąų°├„’@▓Ņ«ÉąįŻ¼ūŅ┤¾Ą─╠ž³c╩Ūį┌ŽÓ═¼Ą─ąŠŲ¼│▀┤ńŽ┬Ż¼┐╔ęįū÷ĄĮĘČć·Ė³ÅVĄ─ųžĘų▓╝īė(Redistribution Layer)ĪŻ╗∙ė┌▀@śėĄ─ūā╗»Ż¼ąŠŲ¼Ą──_öĄę▓Š═īóĢ■ūāĄ├Ė³ČÓŻ¼╩╣Ą├╬┤üĒį┌▓╔ė├▀@śė╝╝ągŽ┬╦∙╔·«aĄ─ąŠŲ¼Ż¼Ųõ╣”─▄ąįīóĢ■Ė³╝ėÅŖ┤¾Ż¼ ▓óŪęīóĖ³ČÓĄ─╣”─▄š¹║ŽĄĮå╬ąŠŲ¼ų«ųąŻ¼═¼Ģrę▓▀_ĄĮ┴╦¤o▌d░ÕĘŌčbĪó▒Īą═╗»ęį╝░Ą═│╔▒Š╗»Ą╚Ą─ā׳cĪŻ
FOWLP╣ż╦ć┴„│╠Ż║
1.Š¦łAĄ─ųŲéõ╝░ŪąĖŅ– ī󊦳AĘ┼╚ļäØŲ¼─zĦųąŻ¼ŪąĖŅ│╔Ė„éĆå╬į¬£╩éõĮī┘▌d░Õ– ŪÕØŹ▌d░Õ╝░ŪÕ│²ę╗Ūą╬█╚Š╬’
2.īėē║š│║Ž– ═©▀^ē║┴”üĒ╝ż╗»š│║Ž─ż
3.ųžĮMŠ¦łA– īóąŠŲ¼Å─Š¦łA╩░╚Ī╝░Ę┼ų├į┌Įī┘▌d░Õ╔Ž
4.ųŲ─Ż– ęįųŲ─ŻÅ═║Ž╬’├▄ĘŌ▌d░Õ
5.ęŲū▀▌d░Õ– Å─▌d░Õ╔ŽęŲū▀ęč│╔ą═Ą─ųžĮ©ąŠŲ¼
6.┼┼┴ą╝░ųžą┬▓╝ŠĆ– į┌į┘Ęų▓╝īė╔Ž(RDL)Ż¼╠ß╣®Įī┘╗»╣ż╦ćųŲįņ I/O Įė┐┌
7.Š¦łA═╣ēK– į┌I/O═Ō▀BĮė┐┌ą╬│╔═╣ēK
8. ŪąĖŅ│╔Ė„éĆå╬į¬– īóęč│╔ą═Ą─╦▄ĘŌ¾wŪąĖŅ





